Thinning silicon wafer full cutting and scribing
As the wafer becomes thinner, the fragmentation and cracking in the cutting process have a greater impact on the chip strength. Therefore, the difficulty of cutting is increasing because of the need to better control the process of fragmentation. In addition, the number of devices using chip film (DAF) as bonding material to stack thinned chips is increasing. Therefore, while controlling the occurrence of burrs, high-quality cutting of wafers with DAF on the back has become a problem.
Other examples of laser full cutting
The back metal film is attached with silicon wafer, gap (gallium phosphide) wafer, InP (indium phosphide) wafer, Gan (gallium nitride) wafer and Ge (germanium) wafer.

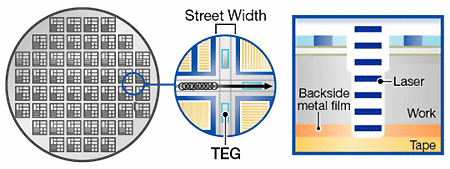
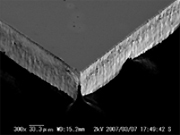
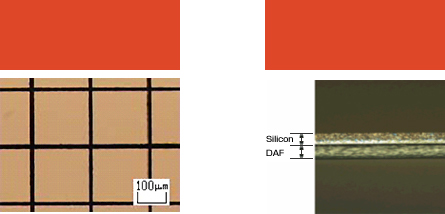









 Home
Home Telephone
Telephone Message
Message





