激光全切割切割工艺
该过程包括将激光馈送到减薄晶片(小于 200 µm)的正面(图案侧)一次,或多次照射晶片直至切割胶带。激光全切割可以提高产量,因为可以提高进给速度。
GaAs(砷化镓)等化合物半导体用于高频器件。使用现有的金刚石刀片对化合物半导体进行刀片切割时,进给速度慢,难以获得高生产率。
随着高度集成化的趋势,基于SiP(System in Package)等技术的高强度薄芯片制造技术已成为必要。然而,使用刀片切割,随着晶片厚度变薄,切割难度增加。
针对此类问题,DISCO对DFL7161激光锯的激光头和光学系统进行了优化,建立了激光全切割应用。
该过程包括将激光馈送到减薄晶片(小于 200 µm)的正面(图案侧)一次,或多次照射晶片直至切割胶带。激光全切割可以提高产量,因为可以提高进给速度。
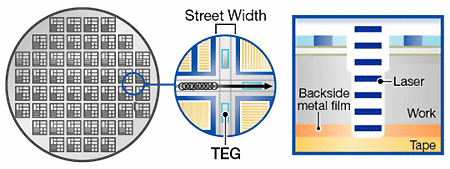
GaAs 化合物半导体的薄晶片切割
在切割过程中,由于材料非常脆,GaAs 晶片很容易发生破损和开裂。因此,难以使用现有的刀片切割来提高进给速度。使用激光全切割切割,可以以比刀片切割快十倍的进给速度进行加工,从而提高产量。(这只是一个例子。实际速度取决于要处理的晶圆。)
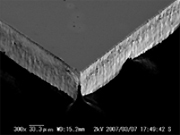
GaAs 晶圆 SEM 图像
* 在处理 GaAs 时,需要额外的设备来去除汽化的 As 气体。
减薄硅片全切划片
随着晶圆变得更薄,切割过程中的碎裂和开裂对芯片强度的影响更大。因此,切割难度正在增加,因为需要更好地控制碎裂的工艺。此外,使用芯片贴膜 (DAF) 作为接合材料以堆叠减薄芯片的设备数量正在增加。因此,在控制毛刺的发生的同时,对背面附有 DAF 的晶片进行高质量切割已成为一个问题。
其他激光全切加工实例
背面金属膜贴附硅片、GaP(磷化镓)片、InP(磷化铟)片、GaN(氮化镓)片和Ge(锗)片。
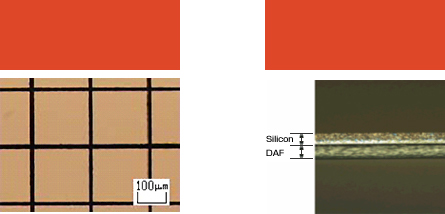
与我们产生合作,还原您产品蓝图里应有的样子!
立即联系我们